
SiP半導體封裝定制化低含氧量回焊爐 HELLER回焊爐設備
HellerIndustries是回流焊技術的,成立于1960年,在二十世紀80年代制造完成HELLER臺全對流式回流爐。HELLER回流焊已應用于集成電路封裝,IGBT,Mini-LED,汽車,醫療,3C,航天,電力等電子工業應用行業。
HELLER回流焊主要特點:
1.多溫區設計,更多溫控點,滿足不同溫度工藝要求;2.的真空效果:有效消除空洞,總空洞面積可控制在1%以下;3.更高的生產效率:的生產能力,平均生產節拍在30-60秒;4.無油真空泵機組,可實現短降壓時間;5.助焊劑回收系統,預防助焊劑殘留;6.通過再真空腔體內安裝加熱絲,小化錫膏液態時間;
SiP芯片尺寸為微米等級,每張Wafer上通常會有數千個芯片,上萬個焊點,以連接功能芯片。如此巨量的焊點,給芯片的封裝焊接帶來了很大的難度。今天我們一起來了解一下焊接工藝。
相比傳統的回流焊焊接工藝,SiP的要求達到了,據統計,焊接不良有40%以上是因為印刷工藝引起的,40%是由焊接引起的。其它20%和錫膏、基板材料有很大關系。對于SiP的可靠焊接,對設備回流焊、焊接工藝、材料(錫膏)都提出了更高的要求,三者缺一不可。
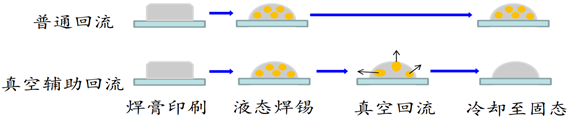
HELLER定制化低含氧量回流焊:
SiP的Wafer焊盤更小、錫膏量更少、芯片更小,對焊接設備的要求、溫度均勻度等工藝參數提出了更高的要求。目前焊接出現的問題包括:
1、芯片位移:芯片焊接之后有移動,需要減少裸芯片焊接后的移動。
2、芯片旋轉:因為芯片本身間距只有0.8mm、0.6mm、0.4mm甚至更小,那么在焊接過程中,芯片本身在氣氛環境下容易旋轉,影響不良。
3、空洞率高:目前氮氣回流焊焊接之后,采用低空洞率錫膏,焊接后空洞率也就控制到10%左右。普通的錫膏,焊接后空洞率可能達到15%以上。空洞率太高,長期使用因為導熱效果或可靠性問題可能會導致產品不良。
4、虛焊:在選擇回流焊的時候,氧氣含量是個很重要的指標,如果氧含量不能控制到100-50ppm以內,甚至更低,有可能導致產品的虛焊。同時溫度均勻度不達標也是一個很重要的因素。整個爐腔內的溫度均勻度如果達不到2度以內,就會導致部分芯片虛焊不良。














































